【パワー半導体の基礎】IGBTの主なデバイス構造を解説|PT型/NPT型/FS型
パワーMOSFETの電流駆動能力を向上するために考案された「IGBT」(insulated-gate bipolar transistor)は、電気自動車のモーター制御装置用インバーター回路*1)などには不可欠です。
しかしながら、IGBTにはその動作原理*2)に起因する問題があるため、更なる特性向上を目指した研究や製品開発が続けられています。
この記事では、IGBT固有の問題を克服するために考案されたデバイス構造の代表的な例を紹介します。
*1)「パワー半導体がEVに不可欠な理由は?」のページをご参照ください。
*2)「IGBTの動作原理」のページをご参照ください。
1.デバイス構造の進化
図1に、代表的なIGBTの断面構造を示します。
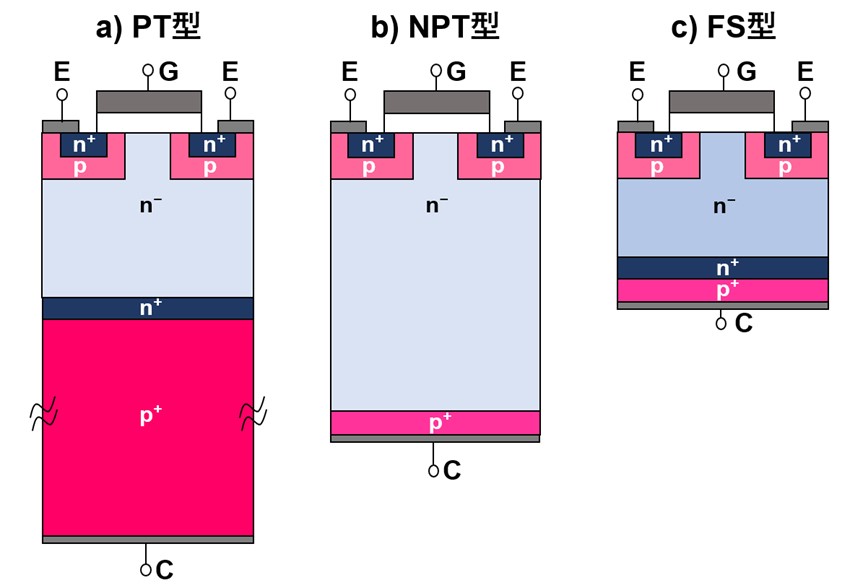
【図1 代表的なIGBTの断面構造】
(G、E、Cは、ゲート、エミッター、コレクターの略。)
これらの構造は、オフ状態のときに低濃度n型領域に広がる空乏層の幅などに注目して分類されており、
1)パンチスルー型(punch through、PT)
2)ノン・パンチスルー型(non-punch through、NPT)
3)フィールド・ストップ型(field stop、FS)
と呼ばれています。
《パンチスルーとは?》
例えばn型MOSFETの場合、ソース・ドレイン間にあるp型領域の不純物濃度が著しく低いと、ドレイン・ソース間電圧を印加した際に、ドレイン空乏層が広がってp型領域を突き抜けて(punch throughして)ソース空乏層に到達して導通状態になってしまい、トランジスターのオン・オフをゲート電圧で制御できなくなってしまいます。このような状態を「パンチ・スルー状態」と呼びます。バイポーラー・トランジスターでも、ベース領域の厚さが薄く不純物濃度が低すぎると、同じ問題が生じます。
一方、IGBTの型の分類に使われている「パンチ・スルー」は、上記の「パンチスルー(突き抜ける)」とは意味が違い、空乏層がある場所に「到達(reach)」するという意味のように思われます。
(1)パンチスルー型(PT型)
パンチスルー(PT)型は、低濃度n型領域内の空乏層が、基板底部に向かって広がってn+層に到達する構造です。
初期のPT型IGBTは、不純物濃度の高いp+型Si基板の上に低濃度の高品質n型エピタキシャル膜を成長して形成されていました。
(図1a)に示した構造の底部にあるp+領域は、厚さが約600μmのp+型Si基板です。
(2)ノンパンチスルー型(NPT型)
ノンパンチスルー(NPT)型では、上記空乏層の厚さが最大値に達しても空乏層が低濃度n型領域内に収まるように、n型領域の厚さと不純物濃度が設定されています。その結果、PT型にあったn+層を必要としませんが、n型領域の厚さがPT型よりも厚くなっています。
NPT型が考案された頃、製造プロセス技術に大きな変革がありました。
NPT型では、初期のPT型のように不純物濃度の高いp+型のSi基板の上に低濃度のn型エピタキシャル膜を成長するのではなく、不純物濃度の低いn型FZ-Si基板*3)を用いています。基板表面にMOSFETを形成した後に、基板の裏面を所望の厚さまで研磨し、基板の裏面から不純物をイオン注入し、ランプ・アニールで不純物を活性化することによって基板底面に薄いp+層を形成するという画期的な方法を用いています。これは、裏面研磨技術とウェハー・ハンドリング技術の進歩がなければ実現できなかった方法です。
これにより、p+領域の不純物濃度や分布を精度良く制御することが可能になり、ホール注入効率を低減させて、PT型の問題であったテール電流を低減することが可能になりました。
その結果、スイッチング損失を低減することができましたが、低濃度n型領域の厚さがPT型よりも厚いため、オン抵抗は増加してしまうという問題が残りました。
*3)通常のSi基板はCZ(Czochralski)法という単結晶引き上げ技術で製造され、その原料は石英(SiO2)るつぼの中で溶かしたSiです。その結果、石英るつぼの内壁からの微量酸素の混入が避けられません。
一方、FZ(floating zone)法では石英るつぼを用いないため、Siインゴット内の酸素濃度を劇的に低減でき、エピタキシャル膜に近い性能が得られるという利点があります。
(3)フィールド・ストップ型(FS型)
フィールドストップ(FS)型もPT型の一種ですが、Si基板の裏面を研磨した構造という点はNPT型と同じであり、デバイスの最終的な厚さも初期のPT型よりも遥かに薄いため、初期のPT型と区別するために、このように別の名称で呼ばれているようです。
FS型では基板底面側からのイオン注入によってp+層の不純物濃度と分布を制御できるため、スイッチング損失を低減できます。
加えて、n+層もイオン注入で形成できるため、低濃度n型領域に広がる空乏層の「電界をn+層領域で止める」ことが可能になりました。その結果、低濃度n型領域の不純物濃度を高め、n型領域の厚さをNPT型よりも薄くすることが可能になり、導通損失をさらに低減することが可能になりました。
裏面研磨技術などの飛躍的進歩により、FS型IGBTでは、低濃度n型領域の厚さを50μm程度まで薄くすることが可能になりました。
また、基板表面に形成するMOSゲートの形状をトレンチ型にすることにより、JFET効果*4)に起因する寄生抵抗成分を完全に消滅でき、更に、微細化技術を駆使してトレンチ型ゲートのチャネル数を増加させてオン抵抗を著しく低減することも可能になりました。
ゲート形状や表面側p型領域の構造、或いはゲート電極への信号パルスの制御方式などを更に改良した新構造デバイスの研究開発が、活発に続けられています。
*4) JET効果の説明は「パワーMOSFETの動作原理」のページをご参照ください。
2.パワーMOSFETとIGBTの補完関係
パワーMOSFETとIGBTは、多岐にわたる製品が設計・製造されていますが、両者の特性は互いに補完し合う関係にあります。
大まかに整理すると、以下のようになります。
- スイッチング速度は、パワーMOSFETの方がIGBTよりも高い。
- 電流駆動能力は、IGBTの方がパワーMOSFETよりも高い。
- パワーMOSFETは、高耐圧化すると電流駆動能力が著しく低下してしまう。
- IGBTは、高電流・高耐圧を両立できるが、スイッチング速度に限界がある。
「パワーMOSFET」は耐圧が約30~800V、電流が数100mA~数A、スイッチング周波数が約20kHz以上の分野で特徴を発揮しており、「IGBT」は耐圧が約400~1800V、電流が15~60A、スイッチング周波数が約20kHz以下の分野で不可欠なデバイスになっています。
パワーMOSFETやIGBTは、Siの物性に起因する性能限界に近付いていると言われていますが、「スーパー・ジャンクション型MOSFET」*5)のようなブレイク・スルー技術も生まれており、今後も進化し続けていくと思われます。
*5)スーパー・ジャンクション型MOSFETの説明は、「パワーMOSFETの構造」のページをご参照ください。
(日本アイアール株式会社 特許調査部 A・Y)