【パワー半導体の基礎】パワーMOSFETの構造を解説 (IGBT/トレンチ型/スーパージャンクション型)

パワーMOSFETは、その基本構造に内在する「寄生抵抗」*1)などの影響により、「耐圧」と「電流駆動能力」はトレード・オフの関係にあります。
この記事では、必要な高耐圧を確保しつつ寄生抵抗を低減するために考案された三つのデバイス構造、
1.IGBT(insulated-gate bipolar transistor)
2.トレンチ型MOSFET
3.スーパージャンクション型MOSFET
の概要を紹介します。
*1) MOSFETの寄生抵抗については「パワーMOSFETの動作原理」のページもご参照ください。
1.IGBT
図1に、従来型パワーMOSFETとIGBTの断面図を示します。
IGBTは、従来のパワーMOSFETの基板底部にp+層を追加した構造になっています。
このp+層を追加したことによって、オン状態では基板底部のp+n+接合が順方向バイアスになり、基板底部から基板内部に大量のホールが流入します。
つまり、n型パワーMOSFETの「電子流」に「ホールによる電流」が追加されて、オン状態での電流駆動能力が飛躍的に向上します。
その結果、n型領域の不純物濃度を低くしてオフ時の耐圧を向上することが可能になります。
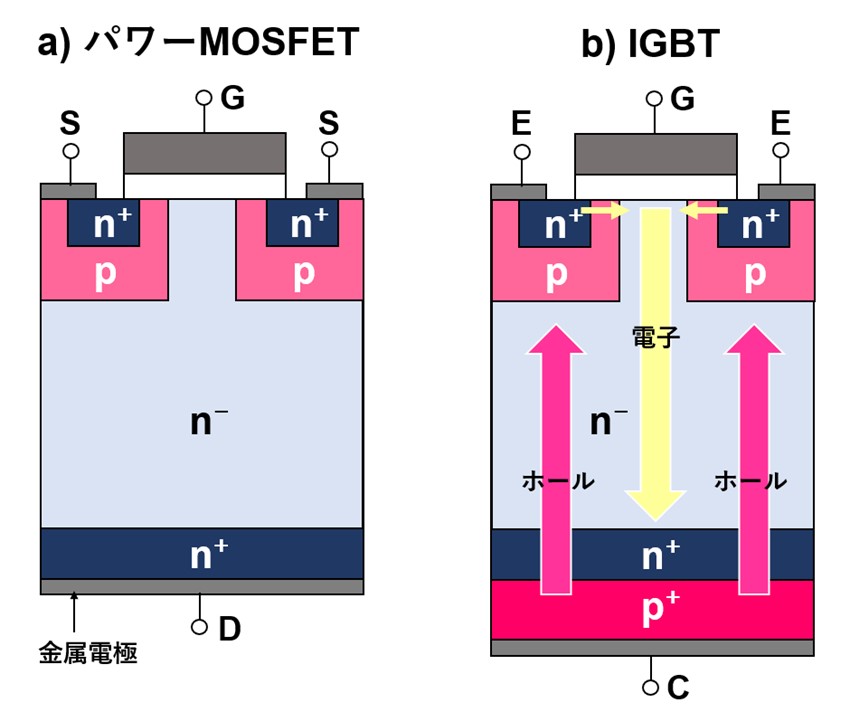
【図1 IGBTの断面構造】
(G、S、D、E、Cは、ゲート、ソース、ドレイン、エミッター、コレクターの略。)
一方、オン状態からオフ状態に切り替わる際には、デバイス内部に蓄積された過剰なホールと電子が再結合によって消滅するまでは再結合電流が流れるため、スイッチング速度が従来のパワーMOSFETよりも遅くなるという欠点があります。
しかしながら、例えば電気自動車のモーター制御用インバーター回路などでは、高い耐圧と高い電流駆動能力という利点が活用されています。
2.トレンチ型MOSFET
図2に、従来型とトレンチ型パワーMOSFETの断面構造を示します。
トレンチ型MOSFETでは、基板表面にトレンチ(溝)を形成して、ゲート絶縁膜とゲート電極をこの溝の中に埋め込んだ構造になっています。
従来のパワーMOSFETでは、「JFET効果*2)」の影響によって横方向の微細化に限界がありますが、ゲート形状をトレンチ型にすることによって、Rjfetの発生原因を完全に消滅できます。その結果、横方向の微細化が可能になり、単位面積当たりのチャネル数(反転層を介した電流経路の数)も増やせるため、オン抵抗を著しく低減できます。
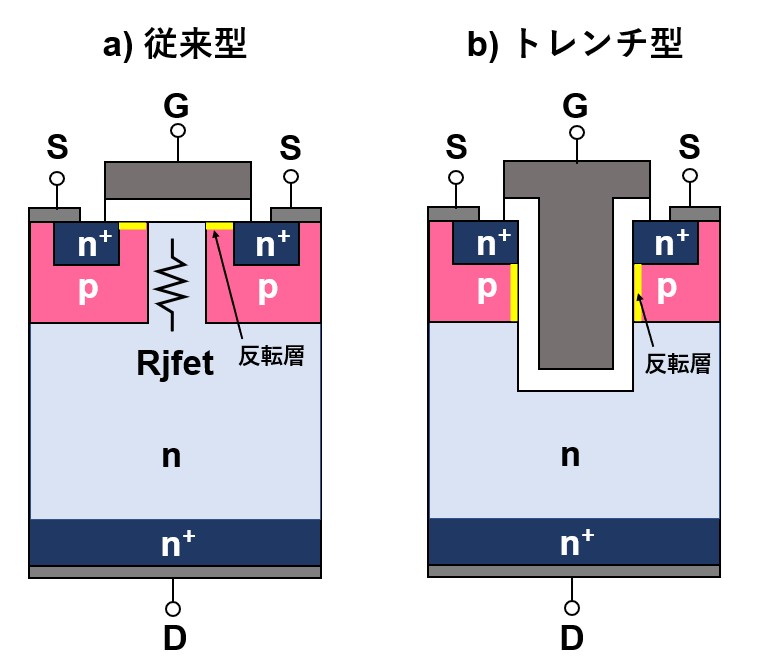
【図2 トレンチ型MOSFETの模式図】
*2) JFET効果の説明は、上記「パワーMOSFETの動作原理」のページをご参照ください。
3.スーパージャンクション型MOSFET
図3に、従来型とスーパー・ジャンクション型MOSFETの断面構造を示します。
スーパー・ジャンクション型MOSFETでは、従来型のp型不純物領域の深さを深くすることによって、従来型の低濃度n型不純物領域に「縦型の周期的pn接合構造」が作り込まれています。
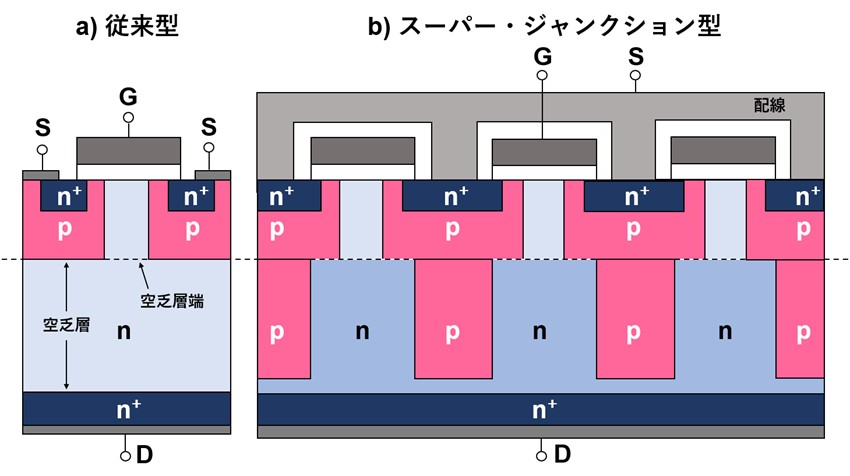
【図3 スーパー・ジャンクション型MOSFETの模式図】
縦長のp型領域とp型領域の間の距離は小さいため、n型領域の不純物濃度がある程度低ければ、n型領域の横方向に広がる空乏層が接触して、n型領域は完全に空乏化した状態になります。隣接するp型領域とp型領域の距離が減少すればするほど、この完全空乏化状態を形成するための不純物濃度を高くすることが可能になります。
従来型では、空乏層内の電界強度がp型領域とn型領域の界面近傍で最も高くなり、その電界強度が限界値以上になると絶縁破壊に至ります。
一方、スーパー・ジャンクション型では、「縦型の周期的pn接合構造」のn型領域が完全に空乏化することによって、この領域内の電位分布が変化して空乏層内の電界強度が減少し、かつ縦方向の限界強度分布が均一になるため、絶縁破壊電圧が向上します。
その結果、n型領域の不純物濃度を高くでき、かつ厚さを低減できるため、寄生抵抗が著しく減少し、電流駆動能力が向上します。
ただし、この縦長p型領域の形状や不純物濃度分布が特性に影響を与えるため、緻密な設計と高度な製造技術が必要です。
スーパー・ジャンクション型MOSFETは、1997年に富士電機(株)の藤平氏が世界に先駆けて発表した画期的な技術*3)であり、「オン抵抗と耐圧の関係」に関する「シリコン(Si)の限界」を打破する性能を有しているため、世界中で多くの研究開発が続けられています。
*3) T. Fujihira:“Theory of semiconductor superjunction devices”, Japanese J. Appl. Phys. Vol. 36, p. 6254-6262, (1997).
4.パワーMOSFETの更なる発展
実際の製品では、電流駆動能力が高ければ良いという単純な話ではなく、寄生容量がスイッチング特性に与える影響や、オン状態やスイッチング時の電力損失の問題も重要です。実際の製品開発では、これらの要因を考慮しながら最適解が追及されています。
Si基板を用いたパワーMOSFETに関する研究開発は活発に行われており、色々なデバイス構造、製造プロセス技術、基板の裏面研磨技術、実装技術などの進歩と共に、更なる性能向上が図られています。
一方、SiC、GaN、Ga2O3、C(ダイヤモンド)のような「ワイドバンドギャップ半導体」と呼ばれる半導体の物性には、Siよりも優れている点が幾つもあります。Si-Si結合よりも化学結合力が強固なため、結合に寄与している最外殻電子の励起が容易でなく、絶縁破壊電界強度がSiよりも遥かに高く、高温動作特性も優れています。
ワイドバンドギャップ半導体に関しても、長年、多くの研究が行われていますが、量産展開するためには、大口径の高品質SiC基板の量産体制確立を待たなければなりませんでした。近年、直径が6インチ(150mm)や8インチ(200mm)のSiC基板の量産が遂に開始されたため、SiC製のパワーMOSFETは、ゲート絶縁膜とSiC基板の界面状態の原子レベルでの制御、不純物の制御、結晶欠陥の制御、長期信頼性、価格等々の課題を克服しながら、急速に発展していくと考えられます。
次回は、IGBTの動作原理について解説いたします。
(日本アイアール株式会社 特許調査部 A・Y)


































