チップレット実装における接合技術動向【提携セミナー】
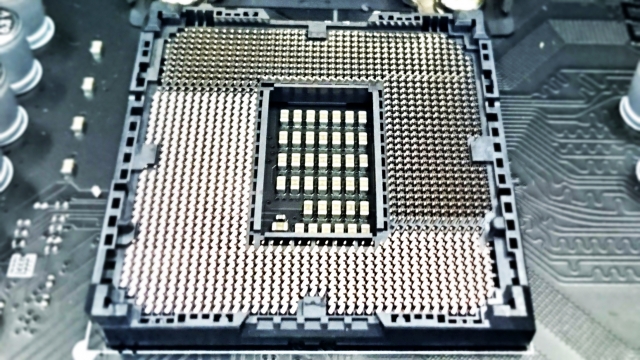
チップレット実装における接合技術動向【提携セミナー】
| 開催日時 | 2026/3/24(火)13:00~14:15 |
|---|---|
| 担当講師 | 大熊 秀雄 氏 |
| 開催場所 | 【WEB限定セミナー】※会社やご自宅でご受講下さい。 |
| 定員 | - |
| 受講費 | 通常申込:22,000円 E-Mail案内登録価格:20,900円 |
チップレット実装における接合技術動向
【提携セミナー】
主催:サイエンス&テクノロジー株式会社
受講可能な形式:【ライブ配信】
- チップレット開発の背景や半導体企業の動向(AMD、インテル、TSMC、サムスン電子、SKハイニックス)
- フリップチップ接合技術変遷、アンダーフィル・ハイブリッドボンディング・装置の最新動向など、
チップレットの実装信頼性を支える接合技術を解説します。
セミナー趣旨
最先端半導体微細化の限界と歩留まり課題が認識され、製造コスト低減や開発期間の短縮でSoCからチップレットへ進展してきた。チップレットでは各種機能の異なるノードの良品半導体を組み合わせフリップチップ接合で一体化(2D, 2.xD,3D)する。このチップレットにおける接合技術は実装信頼性を支える重要な要素技術である。本セミナーではその最新動向を紹介する。
担当講師
(有)エイチ・ティー・オー 代表 大熊 秀雄 氏
[経歴]
1970年:日本IBM(株)入社 野洲工場、米国ポケプシー研究所、野洲研究所にてマザーボードを含む各種有機配線基板、セラミック基板/モジュール、半導体モジュール、Siインタポーザ、液晶モジュール等の実装関連技術の開発、及び新規生産ライン構築に従事。
2003年:(有)BAテクノを設立し、液晶パネル薄型加工の拡販ビジネスを開始
2005年:(有)エイチ・ティー・オーを設立し、エレクトロニクス実装関連の技術支援、ビジネスマッチングを開始。国内外の企業200社以上の支援実績を有する。
国内学会(溶接学会やエレクトロニクス実装学会など)や中立研究機関の運営委員、技術委員、アドバイザーとして長年関与。外資系企業の外部取締役を歴任
セミナープログラム(予定)
1.チップレットの背景と動向(AMD,インテル、TSMC,サムスン電子,SKハイニックス等)
2.フリップチップ接合技術の変遷(各種バンプ形成、マスリフローとTCB等)
3.アンダーフィルの動向
4.ハイブリッドボンディングの動向
5.検査装置、ボンダーメーカーの動向
公開セミナーの次回開催予定
開催日
2026/3/24(火)13:00~14:15
開催場所
【WEB限定セミナー】※会社やご自宅でご受講下さい。
受講料
一般受講:本体20,000円+税2,000円
E-Mail案内登録価格:本体19,000円+税1,900円
E-Mail案内登録なら、2名同時申込みで1名分無料
2名で22,000円 (2名ともE-Mail案内登録必須/1名あたり定価半額の11,000円)
★【S&T会員登録】と【E-Mail案内登録】の詳細についてはこちらをご参照ください。
※E-Mail案内登録をご希望の方は、申込みフォームのメッセージ本文欄に「E-Mail案内登録希望」と記載してください。ご登録いただくと、今回のお申込みからE-mail案内登録価格が適用されます。
配布資料
PDFデータ(印刷可)
主催者サイトのマイページよりダウンロードいただきます(開催2日前を目安にDL可となります)。
お申し込み方法
★下のセミナー参加申込ボタンより、必要事項をご記入の上お申し込みください。