【半導体製造プロセス入門】半導体検査装置の種類と概要(前工程での検査)
![]()
半導体製造では製造工程それぞれに応じて検査が行われます。
今回は、これまでの連載で紹介した前工程における検査と検査装置について解説します。
1.半導体製造での検査の考え方
半導体製造では検査・測定が各製造プロセスの前後に必ず行われます。
プロセス中やプロセス後に欠かせない「モニタリング」と呼ばれる作業も検査・測定といえるでしょう。
半導体製造では基本的にウエハーの検査をしながらプロセスの進み具合を調整するということはできません。また、とりあえず作って後で調整するということも不可能です。
普通の工業製品では、寸法などの基準値が決まっており、その基準値通りに作りますが、半導体の製造では、デバイスの特性を、ある一定の決まった値の中に入れるという考え方をとります。
つまり、許容値を決めておき、できるだけその許容値を小さくしてバラツキを少なくします。
これは、ウエハー上に形成されるトランジスタの特性のバラツキをゼロにすることができないためです。
2.検査装置の種類と使用目的
前工程には、以下の6プロセスがあります。
これらのプロセスは循環型で、同じプロセスが繰り返されます。
したがって、検査も同じく繰り返されることになります。
- (1)洗浄工程
- (2)イオン注入・熱処理工程
- (3)リソグラフィー工程
- (4)エッチング工程
- (5)成膜工程
- (6)研磨工程(CMP・平坦化工程)
では、検査装置の種類を工程別に紹介します。
(1)洗浄工程での検査
洗浄工程では、主にウエハー汚染の程度を検査します。
洗浄効果が十分かどうかを確認する必要があるからです。
例えばパーティクルによる汚染が多いと、不良品が発生し歩留まりが低下します。このパーティクルによる汚染を測定するのが、「ウエハー表面検査装置」と呼ばれる装置です。
原理としては、空気中のチリに強い光を当てるときらきら光る現象(散乱)を利用しています。具体的には、ウエハーにレーザー光を当て、レーザーの散乱光を検知・解析してパーティクルの検出を行います。レーザー光の波長などを調整することにより、パーティクルの大きさと位置を検出することができます。
また、洗浄工程では、ウエハーだけではなく、クリーンルームに浮遊しているパーティクルも検査する必要があります。
パーティクル以外にも、金属や、有機物などの汚染を検査する装置も必要になり、結果として汚染物の種類に応じたそれぞれ専用の検査装置が用意されています。
(2)イオン注入・熱処理工程での検査
イオン注入・熱処理工程では、主にデバイスの抵抗値を検査します。
「半導体ウエハー抵抗率測定」と呼ばれ、イオン注入の目的であるドーピングが意図したとおりに行えたかどうかを確認しています。
ドーピングを行うとウエハー上の結晶構造に不純物が導入され、ウエハーの抵抗値が変化します。この抵抗値の変化を捉え、検査するものです。
なお、イオン注入・熱処理工程の前後でも洗浄工程での検査と同様にパーティクル検査が行われます。
(3)リソグラフィー工程での検査
リソグラフィー工程では、①重ね合わせ検査、②寸法検査、③パターン欠陥検査 の3つの検査が行われます。
① 重ね合わせ検査
半導体製造工程ではウエハーの表面から上に向かって構造を重ねて形成していきますが、重ねるたびにリソグラフィー工程を行う必要があります。そのため、重ねた時にずれがあると、きちんと構造を重ねていくことができません。
既に形成された下の層のパターンと新しく形成するパターンとの重ね合わせの精度は、非常に要求が高くなります。
そこで、リソグラフィー装置に内蔵された光学顕微鏡によって、ウエハーに予め形成された目印とレチクル上の目印のずれを検出します。
リソグラフィー装置はこのずれを修正するべく、位置合わせして実際の露光での制御に反映しています。
② 寸法検査
リソグラフィー工程での寸法測定では「走査型電子顕微鏡(SEM)」が使用されます。
通常の光学顕微鏡は可視光を使用するのに対して、電子顕微鏡では電子線という可視光よりも波長の短い電磁波を使います。
これは、リソグラフィー装置本体の露光に使用する電磁波の波長が短ければ短いほど解像度がよく細かいパターンが描けるのと同じ理屈です。
③ パターン欠陥検査
パターン欠陥の検査には「パターン付きウエハー欠陥検査装置」と呼ばれる装置が必要となります。
図1のように、欠陥のないパターンと欠陥のあるパターンとの比較によって欠陥の検出を行います。
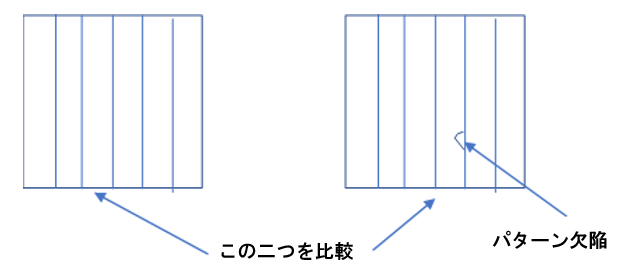
【図1 パターン欠陥検査の概念図】
具体的には、ウエハー表面のパーティクルや欠陥の画像信号をコンピュータに取り込んで、予め取り込んでおいた欠陥なしパターンとの差をとり欠陥の有無を検出します。
(4)エッチング工程での検査
エッチング工程では、①パーティクル汚染、②パターン欠陥、③形状 の3つの検査が行われます。
パーティクルによる汚染の程度は、洗浄工程と同じく、「ウエハー表面検査装置」で調べられます。
パターン欠陥と形状の検査は、リソグラフィー工程と同様に「ウエハー欠陥検査装置」と「SEM」がそれぞれ使用されます。
(5)成膜工程での検査
成膜工程では、①パーティクル汚染、②抵抗値、③膜厚 の3つの検査が行われます。
パーティクルによる汚染の程度は、洗浄工程と同じく、「ウエハー表面検査装置」で調べられます。
抵抗値は、イオン注入・熱処理工程と同じく、半導体ウエハー抵抗率測定装置で検査します。
膜厚の検査には「膜厚測定装置」を使います。
膜厚測定法としては、一般的に分光式が使われています。
分光式では、屈折と呼ばれる現象を利用します。図2に示すように屈折は、光が異なる物質の境界面を通過するとき、光が進む向きが変化する現象で、スネルの法則という原理に基づいて、屈折率と反射方向が関連付けられています。
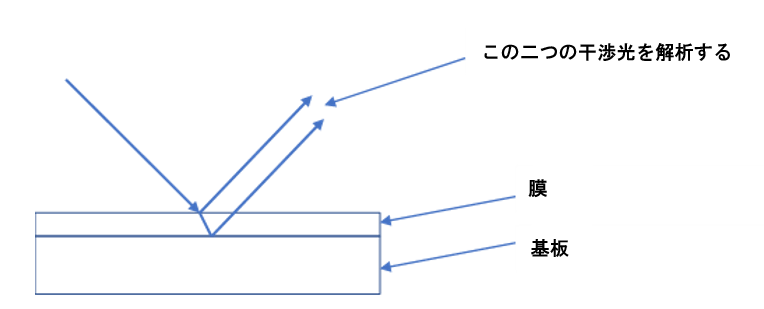
【図2 分光式膜厚測定の概念図】
半導体はベアウエハーの上に膜を重ねて形成していきますが、膜の材質によって、光の伝搬速度が変わります。また同一の物質でも光の波長により伝搬速度が異なります。そこで、その伝搬速度の差を利用して膜厚の測定を行います。膜の中の伝搬速度と空気中の伝搬速度の比を屈折率といいます。
膜に光を当てると膜の表面で反射する光と、膜の内部で屈折して基板表面で反射する光が、重なって光が強められたり弱められたりします。これを「干渉」と呼びます。どれくらい干渉するかは膜の屈折率と膜厚によって決まります。そこで、この光の干渉を解析することにより膜厚を測定することができます。
なお、膜厚が数nmレベルと薄い、反射強度が弱いなどの場合には、単純な分光式では測定が難しくなるため、光の偏光を利用した分光エリプソメトリーと言う方法が用いられます。
(6)研磨工程(CMP・平坦化工程)での検査
研磨工程では、①パーティクル汚染、②パターン欠陥、③膜厚、④平坦度 の4つの検査が行われます。
パーティクルによる汚染の程度は、洗浄工程と同じく、「ウエハー表面検査装置」で調べられます。
パターン欠陥の検査は、リソグラフィー工程と同様に「ウエハー欠陥検査装置」が使用されます。
膜厚は、成膜工程と同じく、「膜厚測定装置」を使います。
平坦度は、膜厚測定と同じく光の干渉を利用して測定します。
レーザー光を平坦度の基準となるミラーにあてつつ、それとは別にウエハー表面にレーザー光を照射します。この二つの反射波を干渉させるようにレンズとハーフミラー(光を半分だけ通すミラー)の位置を設定し、レンズを移動させウエハー表面を走査させます。
干渉の様子をカメラで撮影すると、ウエハーの走査に従って干渉の模様(干渉縞)が観測されます。この干渉縞を解析することによって平坦度を測定します。この平坦度の測定方法は干渉法と呼ばれます。
3.歩留まり管理
以上紹介した各検査結果は、それぞれのプロセスにフィードバックされ、プロセスの安定化やさらなる向上に役立てられます。
また、ウエハーにはそれぞれバーコードや数字が記載され、ウエハー単位での管理が行われています。そのため、これらの検査装置を統合管理して、ウエハーごとの不良箇所のマーキングを行っています。この統合管理は実際にはコンピュータにより一括管理され、前工程全体での歩留まり向上に寄与しています。
これらのフィードバック作業は小さなことの積み重ねですが、この作業によって、前工程全体の品質の向上に寄与しているのです。
(アイアール技術者教育研究所 F・S)




































